Sputtering原理
Sputtering deposition是被激活的入射粒子之间冲撞而释放Target粒子形成的物理蒸镀过程。
此时,若要蒸发Target物质,须具备超过必要热能约4倍的冲击能量,才能从物质中脱离原子。非化学性、热性过程的Physical momentum exchange process几乎可以将所有物质用作Target。
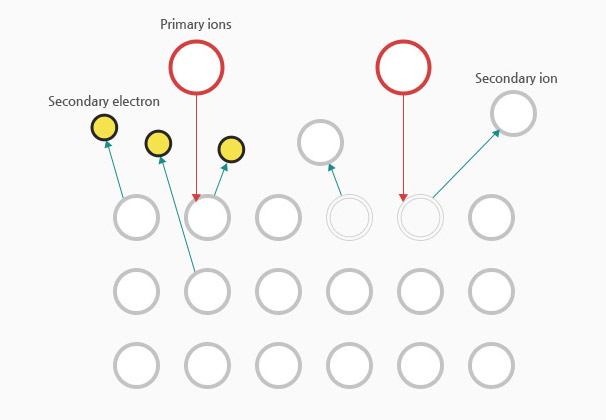
Sputtering mechanism
在真空chamber内放入惰性气体(Ar)后,在Target上施加cathode。 (越重的离子呈现的Sputtering yield越高,但是因为价格低,主要使用Ar。)
从Cathode释放的电子与Ar气体冲撞后使Ar离子化。Ar + e-(primary) = Ar+ + E-(primary) + e-(secondary)
随着Ar进行excite释放电子,能量得到释放,此时发生glow discharge,按照离子与电子共存的gas,呈现特定颜色的plasma。
plasma内的Ar+离子因为高电位差,朝Target(cathode)方向加速,与target的表面冲撞, 中性的target原子被弹出,在基板形成薄膜。
Sputtering的优缺点
-
- 优点
-
针对各种不同材料,均呈现稳定且类似的成膜速度。
可形成均匀的薄膜,优秀的step&defect coverage。
优秀的adhesion。
可实现金属、合金、化合物、绝缘体等各种材料的成膜。
可实现Target冷却,所以可实现target最大化。
通过基板的sputter etching,可以实现pre-cleaning。
可通过O2、N2等reactive sputter形成氧化物、氮化物薄膜。
-
- 缺点
-
成膜速度慢。 (<10Å/sec)
可以用Magnetron sputtering改善High energy deposition可能引发薄膜不均一并产生damage。
成膜后通过热处理,可以减少不均一现象与damage薄膜暴露在电子、UV、离子等环境中被加热。(100~150℃)
视情况有必要冷却基板holder。成膜条件苛刻,相互影响。
应调节Sputtering parameters等。
DC sputtering 的优缺点
-
- 优点
-
结构简单,是最典型的sputter装置。
成膜速度几乎对各种金属都一样。
电流量与薄膜厚度几乎成正比,容易调整。
与RF sputtering相比,成膜速度快。
薄膜具有高均一度。
因为是高能量工艺,贴合强度大。
-
- 缺点
-
Target材料仅限金属。
需要较高的Ar压力。(10 ~ 15 mTorr)
基板很容易过热。
RF sputtering
在DC sputtering,target若为氧化物或绝缘体,则无法sputtering。这样的缺点可以通过RF sputtering解决,尤其在低压力状态下Sputter的物质到达Substrate的期间,Scattering相对减少,可以得到高的Sputtering Yield值。
在DC discharge,二次电子向Ionization precess供应足够能量之前在两极消灭,RF的两个电极与Plasma相比具有Negative potential,因此可以对电子进行Reflect后充分利用在Ionization上。
RF sputtering除了金属,还可以对非金属、绝缘体、氧化物、电介质等进行sputtering,频率虽然应该是低MHz频率,但是按照美国联邦通讯规定的传播管理内容,为了避免干扰广播频率,规定要使用13.56MHz的高频电源。
Sputter的物质到达Substrate的期间,Scattering相对减少,可以得到高的Sputtering Yield值。
Magnetron sputtering
为了增加Target的离子化,在Target背面安装永久磁铁或电磁铁,将cathode释放的电子局部搜集在target外侧形成的磁场内,促进与Ar气体原子的冲撞,这是提高Sputter yield的方法。
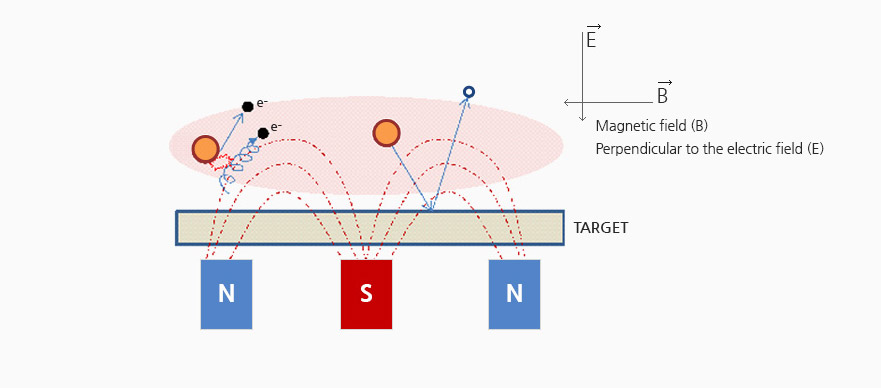
-
- 优点
-
Sputtering效率将提高。
通过电子的涡流运动,可以减少在电子基板与薄膜上的冲撞。
基板温度上升效果较小。
针对SiO2、Al2O3等绝缘体,成膜速度也快。
可以实现电介质材料的sputter或reactive sputter。
在特定input power,成膜速度均一。(±10%)
通过适当排列永久磁铁并使用shiled,可以轻松调整
薄膜厚度的Uniformity。
-
- 缺点
-
磁场需垂直于target表面。
因为磁场附近有选择性的sputter,对target的消耗性大。(效率约为25%)
对有磁性的材料(Co、Ni等)进行sputtering时,
导致外侧的剩余磁场过小。
要使用1/8” ~ 1/32”程度的薄target。
Reactive sputtering
与Bias sputtering的作用完全相反,为按照任意目的而形成氧化物或氮化物等薄膜(电介质薄膜等),使用reactive sputtering。
该方法与一般的sputtering相同,但是除了Ar气体,同时供应微量氧气或氮气,从而能够获得所需化合物的薄膜。
与直接对氧化物或氮化物target进行sputter相比,凭借Reactive sputtering形成的化合物薄膜,在制造、纯度与价格方面都具有优势。
因为target上的气态原子十分不稳定,容易与反应性气体发生反应,而且到达基板的原子在薄膜状态下反应速度也很快。
在Reactive sputtering过程中提高基板温度,可以加快化合物形成速度,从而提高成膜速度。。
但是Reactive sputtering,会缩短真空压力gauge或glow discharge用filament的寿命,EC sputter期间在target表面形成氧化物或氮化物等绝缘层,从而降低sputter效率。
这种现象若为DC sputtering,可以从sputter初期开始旋转target背面的永久磁铁或改变磁铁电流,进行改善。
磁性体
磁性体是磁场内磁化物质的统称,在宏观意义上,空气也包含在磁性体内。
简而言之,虽然在程度上有所差异,但存在于地球上的所有物质都可以称为磁性体。
只是其磁性(被磁铁吸附的性质)水平会依不同物质(素材)呈现出很大不同。
像铁一样呈现强力磁性的物体被称为强磁性体,而像铝一样几乎没有磁性的物质称为顺磁性体。这里的顺磁性体也被称为非磁性体。顺磁性体中还有像金或铜一样呈现抗磁性的物质,这类物质还有一个特别的名字,那就是抗磁性体。抗磁性体具有与强磁性体完全相反的性质,但是因为其作用十分微弱,因此包含在顺磁性体分类中。
- 强磁性体
- 铁(Fe)、镍(Ni)、钴(Co)
- 顺磁性体
- 铝(Al)、铬(Cr)、铂(Pt)
- 抗磁性体
- 铜(Cu)、金(Au)、银(Ag)
自发磁与温度的关系
如果是低于居里点的温度,铁等强磁性体的电子自旋朝向某一方向排列。排列的自旋越多,那么该磁性体就越容易成为磁铁,在外部磁场受到磁化。
此时,因为认为是在自旋方向上形成了迷你磁铁,因此可以看做是一种原子磁铁。
总之,强磁性体可以自然地具备磁性,并将其称为天然磁性。
自然磁性具有温度依赖性,在-273℃(绝对温度)达到最大值。
随着温度上升,磁性减弱,在居里点失去所有磁性。
即,变成非磁性体(顺磁性体)。
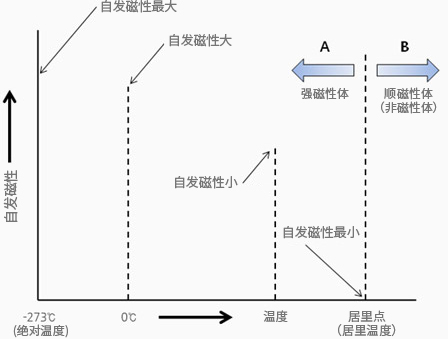
磁化(Magnetizing)
磁化按照磁化方法分为3种。磁化是指排列磁性体内的原子磁铁。在进行磁化之前,磁性体的N极与S极
相互前后相连,处于磁力线不能释放到外部的状态(无磁化)。
但是,若在外部施加强烈N极与S极磁界,这些原子磁铁将排列成与外部磁界平行的状态,变成能够向外部释放磁力线的结构。
像这样,在磁性体外部施加强烈磁界,让原子磁铁因刺激而按照一定方向排列的过程,称为磁化。
最常用的磁化方法是在线圈上施加足够大的直流电流,形成强烈磁界{也被称为磁场。意为磁力线形成势力的空间},
并在其磁界内放入磁性体磁化。视情况还可以使用对铁氧体进行弱磁化的方法,不直接施加直流电源,
而是将磁性体直接接触强烈稀土类永磁体Nd-Fe-B等磁铁,从而令其磁化。
磁导率
磁导率是磁通密度及与其相对应的磁化力之比(磁通密度/磁化力),是指通过磁性体的磁力线数。
与磁导率类似的概念有相对磁导率,这是将磁材料的磁导率除以真空磁导率的比值。
相对磁导率最高的是铁,其值为120~20000。其他强磁性体有钴为270,镍为180。
另一方面,铝、铜等顺磁性体(非磁性体)的相对磁导率接近1,几乎与空气或真空状态相同。
因为铝、铜的相对磁导率非常低,因此即便是金属,磁力线也可以轻松通过。
可以说完全没有屏蔽磁力线的力量。
与此相比,磁力线很难通过铁等强磁性体,一旦进入到磁性体内,除非达到磁饱和,则不会穿出磁性体。
磁滞回线(Hysteresis loop)
若慢慢磁化铁等强磁性体,磁通密度与磁化力的关系将呈现0 A B C等特性。
但是,若在饱和状态(饱和点C)慢慢减小磁化力,磁通密度也相应减少,变成C D。若继续施加负方向磁化力,那么将经过E,到达F。
相对磁导率最高的是铁(Fe),其值为120~20000。其他强磁性体有钴为270,镍为180。
另一方面,铝、铜等顺磁性体(非磁性体)的相对磁导率接近1,几乎与空气或真空状态相同。
因为铝、铜的相对磁导率非常低,因此即便是金属,磁力线也可以轻松通过。可以说完全没有屏蔽磁力线的力量。
与此相比,磁力线很难通过铁等强磁性体,一旦进入到磁性体内,除非达到磁饱和,则不会穿出磁性体。

Magnetron sputtering
一般情况下,可通过磁滞曲线了解磁性材料的特性,但对于永久磁铁,则利用BH曲线。好的磁铁一般指磁力强的磁铁,而这与磁通密度成正比。
但是,即使磁通密度再大,如果保磁力弱,也很难持续稳定地维持其磁力。因此,好的磁铁可以说是磁通密度大且保磁力大的磁铁。
下列曲线表示退磁曲线,曲线上的任一点“A”的“b”和“H”的值将成为Ba和Ha,而Ba X Ha值被称为磁能积。
在曲线上,Ba X Ha最大点“D”称为最大磁能积,表示为“BHmax”,其单位是“X10GOe”。
为轻松了解退磁曲线上任一点的磁能积,提前将连接相同BH点的曲线画出来。

在该状态下,逐渐减少外部磁场,将磁通密度减少成A→b,外部磁场为0(zero),那么将会到“b”点,从而剩下0(zero)b的磁通密度。
我们将该值称为Residual Induction,表示为Br,单位是G(Gauss)。
如果施加反方向的外部磁场,磁通密度将逐渐减少,到达“c”点。为了让其到达“c”点而需要的反方向的外部磁场的强度称为保磁力,表示为Hc,单位是Oe(Oersted)。